スパッタリング成膜のご相談・カスタマイズサービスは株式会社アドバンスト・スパッタテックへ

自社製スパッタ成膜源販売
および海外製品の輸入販売
- Sales Service -
国内開発技術×海外実績技術で
多様なニーズに対応。
自社製の低ダメージスパッタ成膜源と
輸入製品で、現場の課題を解決します。
併せて、成膜サービスにも対応させて頂いております。
弊社では、独自構造を用いることで、低ダメージ性と高生産性を両立したスパッタ成膜源の自社開発に成功し、絶賛販売中です。
さらに、海外パートナー企業様との連携により、各種スパッタ成膜源やイオン照射源などの輸入販売もおこなっています。汎用・実験用から特殊用途まで、国内外の技術を融合し、お客様の用途や設備に最適な構成をご提案いたします。
加えまして、国内協力会社様とのコラボレーションにより、一般的なスパッタ成膜源を使用したITOや金属の成膜サービスもおこなっています。お気軽に、ご相談ください。
Product Introduction
自社製スパッタリング成膜源、絶賛販売中
1
ターゲットを向かい合わせて反跳アルゴンを基板に当てない
2
プラズマを磁気回路によって十分に遮蔽して基板に当てない
3
プラズマによって加熱されるフィラメント状の活性陽極へ優先的に電子を流れ込ませ、プラズマが基板(この写真では紙面の手前)方向へ漏れ出すことを更に抑制(特許登録済の新技術)
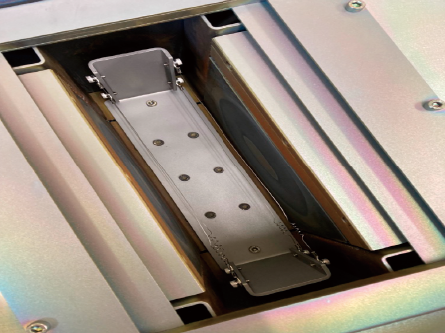
(a)試作・低ダメージ
スパッタ成膜源
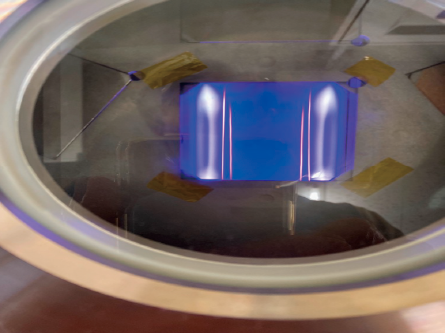
(b)ITO 成膜中の様子
これら独自技術を組み合わせ、
低ダメージ性と従来比約2倍の成膜速度の両立を実現しました。
横浜市の助成事業にも採択されており、ペロブスカイト太陽電池向けの装置開発も進行中。
国内特許取得済・海外出願済の技術により、次世代のスパッタ成膜プロセスをご提供します。
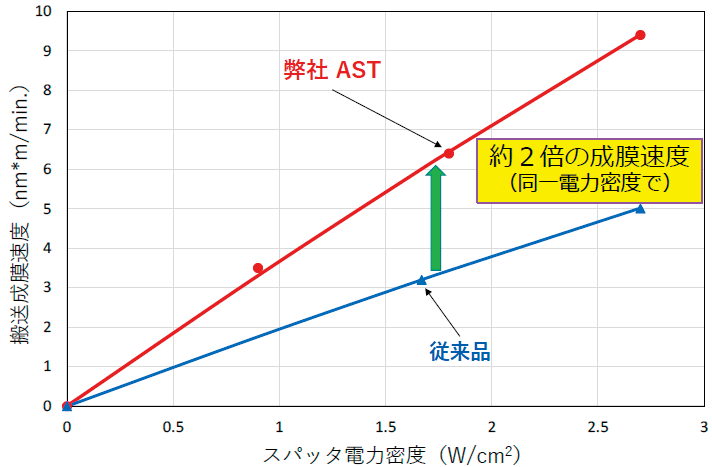
※データーは、社内実験装置に搭載した「低ダメージスパッタ成膜源」で得た値
Product Introduction
取扱い商品・サービスの紹介
平板型スパッタ成膜源による成膜サービス
一般的な平板矩形スパッタ成膜源を使用した、インライン型装置
或いはカルーセル型装置にて国内で成膜します。
ITO、Cr、Cu等の成膜に対応しています。
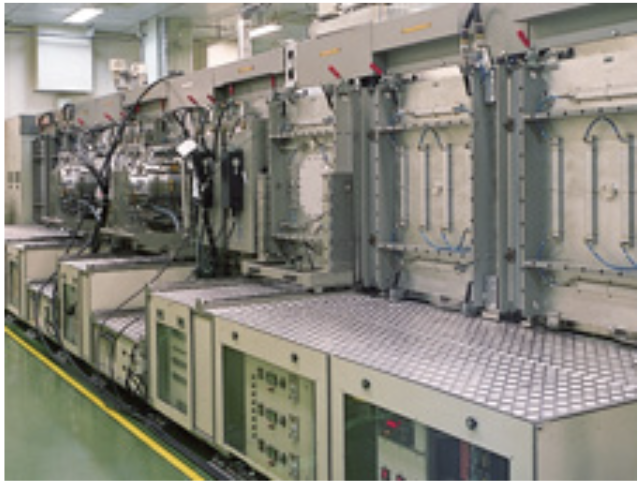
主な特徴
お客様のご要望に応じたITO膜への対応
高い密着性が付与されたCr/Cu積層膜の提供
ガラス基板につきましては、成膜と併せてお見積させて頂きます
ご要望に適した成膜サービスを提供します
少量から対応させて頂いておりますので、お気軽にご相談ください

主な仕様
基板サイズ
400mm x 500mm 程度まで(2025年末までに拡大を計画実施中)
使用スパッタ成膜源
一般的な平板型マグネトロンスパッタ成膜源
成膜材料
ITO、Cr、Cu、その他はご相談ください
成膜基板温度
無加熱 〜 230℃程度
円形平板型マグネトロン
スパッタカソード
円形平板型
一般的な実験用スパッタ装置に利用されるタイプです。
成膜の目的に応じて磁気回路を交換できるのが特徴です。

主な特徴
ターゲット材料に適した磁場が適用可能
磁気回路はモジュール式なので交換可能
超高真空に対応
オプションとアクセサリが豊富
磁気回路の腐食を避けるため磁気回路は冷却水に浸されない設計

主な仕様
ターゲットサイズ
直径2 ~ 8 インチ
適用電源
CW-DC, Pulse-DC, MF, RF
磁場強度
400~1300Gauss (サイズに依る)
オプションアクセサリ
シャッター、角度調整、T-S間距離調整、膜防着リング、その他
矩形平板型マグネトロン
スパッタカソード
矩形平板型
基板通過成膜型スパッタ装置に利用されるタイプです。
用途や取付方法に応じて形式を選択できます。

スパッタガス導入仕様

RF(高周波)仕様

側面取付型

T-S 調整可能仕様
主な特徴

多数のターゲット幅に対応可能

インナー型スパッタ成膜源

アウターフランジ型スパッタ成膜源
主な仕様
ターゲット長
50, 70, 90, 120, 150 cm
ターゲット利用率
最大40% ワイドエロージョン仕様設計のため、アークの発生リスクが軽減されます。
磁場強度
通常~強磁場にて可能
適用電源
CW-DC, Pulse-DC, MF, RF
オプション
磁気回路を揺動させる仕様あり
円筒型マグネトロン
スパッタカソード
円筒ターゲット回転型:ロータリーカソード
基板通過成膜スパッタ装置に利用されるタイプで、ターゲット形状を円筒形にして回転させることにより、ターゲット利用率を大幅に高めていることが特徴です。
用途や取付方法に応じて形式を選択できます。

カソード背面から回転導入する仕様

カソード側面から回転導入する仕様
優位な特徴
内外二重絶縁構造による高い安全性
複数の冷却水シーリングによりターゲット回転時の漏水を防止
最適化された大電流対応ブラシによりターゲット回転時の安定な放電を実現
回転シャフト表面への超高度コーティングにより摩耗を低減
磁力線の広がり角度が小さい

棒状磁気回路(マグネットバー)
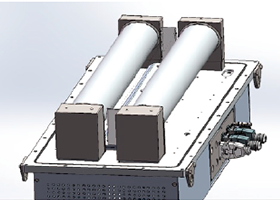
デュアルマグネトロン仕様
棒状磁気回路の主な仕様
回路
膜厚分布補正機能付き磁気回路
磁場位均一性
±2%
高ターゲット利用率
75 ~ 85%
オプション
スパッタ方位オンライン調整
背面陽極放射型イオン照射源
矩形、円形
アルゴン(Ar)イオンを照射することで基板表面をクリーニングしたり、酸素イオン(O+)を照射することで膜表面を酸化させたりすることができます。
円形は一般的な実験装置に、矩形は基板通過型装置に適しています。

矩形

円形
優位な特徴
最適な磁場設計により電極の耐イオン衝撃性が低減され、
汚染防止性能とメンテナンス性が大幅に向上
イオン化ガス導入経路の最適化により、
イオン放射の優れた均一性を実現
オプションとして、電極のグラファイト仕様を選択可能
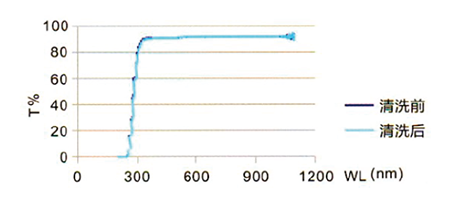
基板への汚染がないことが、イオン照射前後での光透過率に変化が無いことで検証された。
棒状磁気回路の主な仕様
動作に必要な電源は1台ですみます。
矩形
最大放電電圧
2500V
最大放電電流
5 A/cm
イオンエネルギー
150 ~ 1250 V
プロセス圧力範囲
3E-2 ~ 1E0 a
イオン化ガス流量
0 ~ 50 ccm
冷却水配管外径
φ8
イオン化ガス種
Ar, O2, N2
装着方式
内側装着/外側フランジ型
円形
最大放電電圧
2000V
最大放電電流
0 ~ 3 Aで調整可
イオンエネルギー
150 ~ 1000eV
プロセス圧力範囲
3E-2 ~ 1E0Pa
イオン化ガス流量
0 ~ 50sccm
冷却水配管外径
φ8
イオン化ガス種
Ar, O2, N2
装着方式
内側装着/外側フランジ型
輸入商品ラインアップ
種類
各種サイズ
種類
円形平板型スパッタ源
各種サイズ
直径:2インチ
直径:3インチ
直径:4インチ
直径:5インチ
直径:6インチ
直径:8インチ
種類
矩形平板型スパッタ源
各種サイズ
長さ:50cm
幅:ご相談
長さ:70cm
幅:ご相談
長さ:90cm
幅:ご相談
長さ:120cm
幅:ご相談
長さ:150cm
幅:ご相談
-
種類
円筒型スパッタ源
各種サイズ
-
円筒ターゲット
外径:70mm
円筒ターゲット
外径:100mm
-
円筒ターゲット
外径:150mm
-
種類
円形イオン照射源
各種サイズ
-
-
直径:105mm
-
-
-
種類
矩形イオン照射源
各種サイズ
-
-
長さ:1 m
-
-
-
※別途その他サイズをご希望のお客様はオプションにて対応可能です。

