スパッタリング成膜のご相談・カスタマイズサービスは株式会社アドバンスト・スパッタテックへ

トピックス & お知らせ
- Blog -
お知らせ詳細
「スパッタリングとその原理」
「スパッタリング成膜とその原理」
1.スパッタリングとは
一言で表現すると、真空中でプラズマを発生させ、ナノレベルの薄膜を基板上に形成させる技術です。金属のスパッタリング成膜は半導体をはじめ多くの分野で応用されています。透明導電性薄膜(透明電極薄膜)の形成には真空蒸着法よりスパッタ砲が有利なため、液晶ディスプレイや有機E Lディスプレイ、タッチパネル等、最近ではペロブスカイト太陽電池を含め多くの実績があります。
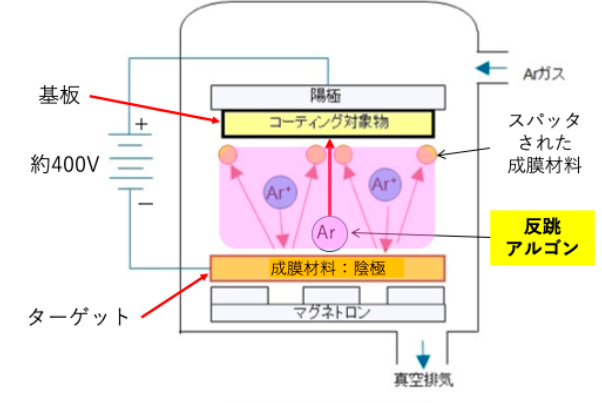
図1.スパッタリング装置の概要図
図1にスパッタリング装置の概要を示します。 この図は、本当に概要にすぎません。
成膜材料の個体は板状であってターゲットと呼ばれており、スパッタ電源のマイナス極が接続されているため陰極になります。陽極はコーティング対象物(大体の場合は板状の基板)の裏側に配置されている想定で、スパッタ電源のプラス極が接続されています。
この状態にて、真空ポンプで 5 x 10-4Pa 程度以下の真空圧力まで排気した後、アルゴンガスで0.2〜1.0Pa程度の真空圧力に保ち、上記した陰極と陽極の間に直流電圧を印加すると、放電が始まりアルゴンプラズマが発生し、アルゴンがプラスのアルゴンイオンAr+とマイナスの電子e-に解離(分離)します。このプラズマ中のAr+がマイナスに印加されたターゲット材料に電気的な力で激しく衝突し、その際にターゲット材料の一部が小さな粒子(概ね原子や分子のサイズのスパッタ粒子)の状態で基板に向かって弾き出されて基板表面に付着します。この現象を用いた成膜法がスパッタリング成膜と呼ばれています。
2.スパッタリングの原理
図1と図2は、ほぼ同じ図ですが、視点を少し変えて説明するため敢えて分けています。
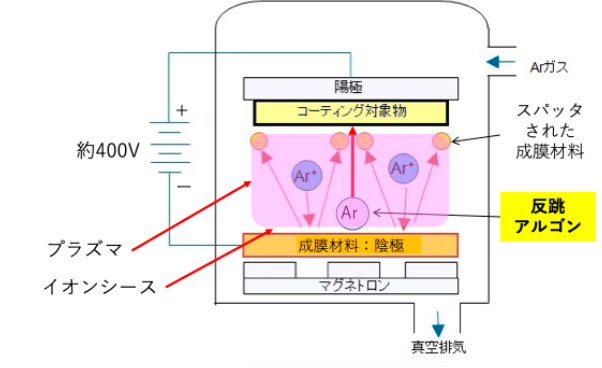
図2.スパッタリングの原理説明図
図2中の内容は、図1と全く同じですが、一部視点を追加しています。それは、イオンシースです。イオンシースとは、スパッタリングやグロー放電のターゲット前に形成されるプラズマとカソード表面との間の電位降下領域のことです。このマグネトロンスパッタにおけるイオンシースの厚さは概ね1mm以下なので実際に見ることが困難なため、私は残念ながら直視したことがありませんが、以下の計算式で求められます。

一部が繰り返しになりますが、真空ポンプで 5 x 10-4Pa程度以下の真空圧力まで排気した後、アルゴンガスで0.2〜1.0Pa程度の真空圧力に保ち、上記した陰極と陽極の間に直流電圧を印加すると、放電開始電圧で放電が開始しプラズマが発生し、その後速やかに放電維持電圧で安定します。図2(図1も)ではターゲットの下部にマグネトロンと記された磁気回路が配置されています。この目的は、前記した放電維持電圧が1000V前後、放電維持電圧が電力一定制御条件の下で400V前後(両者ともアルゴンの圧力や前期したマグネトロン磁気回路の磁力の強さで変化します)に低下させプラズマ密度を濃くできる(電流量を増加できる)ことで、ターゲット材料がスパッタされて基板に付着する速度(スパッタレート)を早くすることができます。そのため、現状では殆どのスパッタ装置でマグネトロン方式が使われています。この400V前後の電圧は、計測が容易なスパッタ電源の出力電圧を通常は意味します。そして、この電圧は、スパッタ現象が起きている空間のプラズマ(陽極側のイオンシースを含む)と陰極(ターゲット)直上のイオンシースで分割され、プラズマ密度に依るプラズマインピーダンスにも依存しますが、80%〜90%の電圧が陰極(ターゲット)直上のイオンシースに掛かっているとされています。この電位降下(上記例の場合は、400V x 0.8~0.9 = 320V~360V)により、アルゴンイオンはこのイオンシースの大きな電場(340V / 0.00083m = 410,000 V/m)で加速され、ターゲット表面に衝突しスパッタ粒子を飛び出させます。
さて、放電が開始(=プラズマが発生)された瞬間からスパッタ現象(スパッタリング現象)が始まります。プラズマ(この場合はアルゴンプラズマ)はアルゴンがプラスのアルゴンイオン(Ar+)とマイナスの電子(e-)に解離(分離)した状態です。このプラズマ中の(Ar+)がマイナスに印加されたターゲット材料に電気的な力で激しく衝突し、その際にターゲット材料の一部が小さな粒子(概ね原子や分子のサイズのスパッタ粒子)の状態で基板に向かって弾き出されて基板表面に付着します。殆どの場合、スパッタ粒子は電気的に中性なので、電場の影響を受けずに進行します。同時に、ターゲットへ衝突したAr+は、陰極として作用しているターゲット表面で電子を受け取り、電気的に中性の状態で弾き返され、基板に向かって高速で(高い運動エネルギーを持った状態で)進みます。これは反跳アルゴンと呼ばれ、基板および成膜中の膜へ良かれ悪しかれの影響を与えます。
ここで、1つのAr+が弾き出すターゲット材料原子ないし分子の個数は、スパッタ率と定義されており、スパッタ率が大きい材料ほどスパッタレート(成膜速度)を大きくできます。
今までの話の中では、ターゲット材料と基板が共に導電性物質の場合です。では、ターゲット材料が絶縁体の場合はどうなるかと言いますと、直流のスパッタ電源では放電できないため、高周波(概ね10MHz以上:実際には使用できる周波数が法律で規制されているので、13.56MHzとか27.12MHzとか40.68MHzとかが使用でき、最も一般的なのは13.56MHz)のスパッタ電源を使用することで可能になります。この話は、また別のトピックスで改めてさせて頂きます。
それでは、基板がガラスやPETフィルムのような絶縁体の場合、前記した図1の構成では絶縁体基板の裏側に陽極が配置されているため、放電しない(プラズマが発生しない)ことになります。しかしながら、この場合、実際には放電しプラズマが発生します。したがって、実際には陽極として作用する部位が異なるのです。それは、ターゲットシールド或いはアースシールドと呼ばれる部品が、少なくともマグネトロンスパッタリングの場合には陽極として作用します。この話も、また別のトピックスで改めてさせて頂きます。図1と図2には、ターゲットシールドないしいはアースシールドが明記されていませんので、ご了承ください。さらに図1と図2では、プラズマの形状とマグネトロン磁気回路の形状が不明確なので、これはマグネトロンスパッタに特化したトピックスで話をさせて頂きます。
※.次回の予告
最後までお読み頂きまして、誠にありがとうございました。
今回は初回なので、スパッタリングの基本的なお話をさせて頂きました。既にご存知の内容だったかも知れませんが、もしかしたらなるほどと思われた点もあったのではないかと拝察します。
次回は、放電開始のメカニズムについてお話ししたいと考えております。私の話は、スパッタリングという技術に触れて間もない研究者や技術者の方々が、なるべくスパッタ装置の設計や使用に役立つよう配慮したいと考えています。
異論や反論がございましたら、どうぞお気軽にご意見を「お問い合わせ」フォーマットにてお寄せください。トピックス記事のリクエストも大歓迎です。可能な限りお応えしたく存じます。
末筆になりましたが、私の日本語に不自然な箇所がありましても、ご寛大なお心でご容赦ください。それでは次回、またご覧いただければ幸甚です。
1.スパッタリングとは
一言で表現すると、真空中でプラズマを発生させ、ナノレベルの薄膜を基板上に形成させる技術です。金属のスパッタリング成膜は半導体をはじめ多くの分野で応用されています。透明導電性薄膜(透明電極薄膜)の形成には真空蒸着法よりスパッタ砲が有利なため、液晶ディスプレイや有機E Lディスプレイ、タッチパネル等、最近ではペロブスカイト太陽電池を含め多くの実績があります。
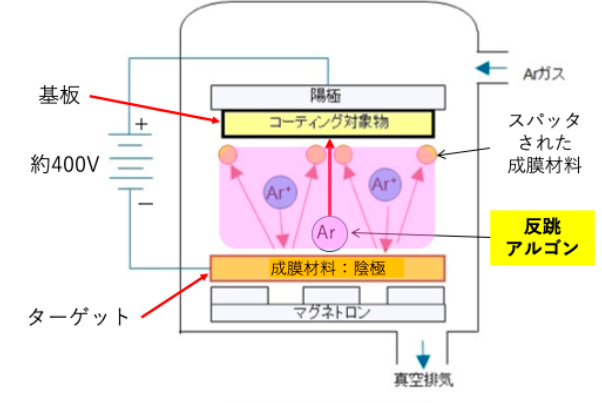
図1.スパッタリング装置の概要図
図1にスパッタリング装置の概要を示します。 この図は、本当に概要にすぎません。
成膜材料の個体は板状であってターゲットと呼ばれており、スパッタ電源のマイナス極が接続されているため陰極になります。陽極はコーティング対象物(大体の場合は板状の基板)の裏側に配置されている想定で、スパッタ電源のプラス極が接続されています。
この状態にて、真空ポンプで 5 x 10-4Pa 程度以下の真空圧力まで排気した後、アルゴンガスで0.2〜1.0Pa程度の真空圧力に保ち、上記した陰極と陽極の間に直流電圧を印加すると、放電が始まりアルゴンプラズマが発生し、アルゴンがプラスのアルゴンイオンAr+とマイナスの電子e-に解離(分離)します。このプラズマ中のAr+がマイナスに印加されたターゲット材料に電気的な力で激しく衝突し、その際にターゲット材料の一部が小さな粒子(概ね原子や分子のサイズのスパッタ粒子)の状態で基板に向かって弾き出されて基板表面に付着します。この現象を用いた成膜法がスパッタリング成膜と呼ばれています。
2.スパッタリングの原理
図1と図2は、ほぼ同じ図ですが、視点を少し変えて説明するため敢えて分けています。
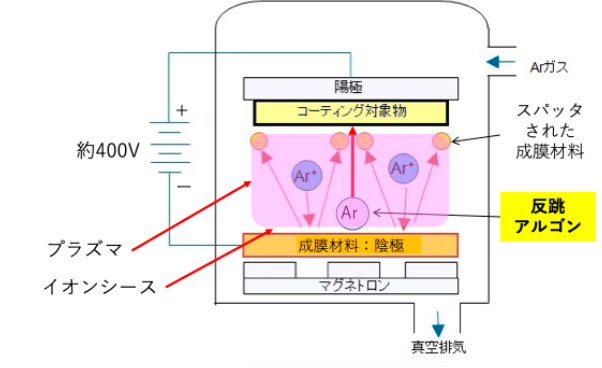
図2.スパッタリングの原理説明図
図2中の内容は、図1と全く同じですが、一部視点を追加しています。それは、イオンシースです。イオンシースとは、スパッタリングやグロー放電のターゲット前に形成されるプラズマとカソード表面との間の電位降下領域のことです。このマグネトロンスパッタにおけるイオンシースの厚さは概ね1mm以下なので実際に見ることが困難なため、私は残念ながら直視したことがありませんが、以下の計算式で求められます。

一部が繰り返しになりますが、真空ポンプで 5 x 10-4Pa程度以下の真空圧力まで排気した後、アルゴンガスで0.2〜1.0Pa程度の真空圧力に保ち、上記した陰極と陽極の間に直流電圧を印加すると、放電開始電圧で放電が開始しプラズマが発生し、その後速やかに放電維持電圧で安定します。図2(図1も)ではターゲットの下部にマグネトロンと記された磁気回路が配置されています。この目的は、前記した放電維持電圧が1000V前後、放電維持電圧が電力一定制御条件の下で400V前後(両者ともアルゴンの圧力や前期したマグネトロン磁気回路の磁力の強さで変化します)に低下させプラズマ密度を濃くできる(電流量を増加できる)ことで、ターゲット材料がスパッタされて基板に付着する速度(スパッタレート)を早くすることができます。そのため、現状では殆どのスパッタ装置でマグネトロン方式が使われています。この400V前後の電圧は、計測が容易なスパッタ電源の出力電圧を通常は意味します。そして、この電圧は、スパッタ現象が起きている空間のプラズマ(陽極側のイオンシースを含む)と陰極(ターゲット)直上のイオンシースで分割され、プラズマ密度に依るプラズマインピーダンスにも依存しますが、80%〜90%の電圧が陰極(ターゲット)直上のイオンシースに掛かっているとされています。この電位降下(上記例の場合は、400V x 0.8~0.9 = 320V~360V)により、アルゴンイオンはこのイオンシースの大きな電場(340V / 0.00083m = 410,000 V/m)で加速され、ターゲット表面に衝突しスパッタ粒子を飛び出させます。
さて、放電が開始(=プラズマが発生)された瞬間からスパッタ現象(スパッタリング現象)が始まります。プラズマ(この場合はアルゴンプラズマ)はアルゴンがプラスのアルゴンイオン(Ar+)とマイナスの電子(e-)に解離(分離)した状態です。このプラズマ中の(Ar+)がマイナスに印加されたターゲット材料に電気的な力で激しく衝突し、その際にターゲット材料の一部が小さな粒子(概ね原子や分子のサイズのスパッタ粒子)の状態で基板に向かって弾き出されて基板表面に付着します。殆どの場合、スパッタ粒子は電気的に中性なので、電場の影響を受けずに進行します。同時に、ターゲットへ衝突したAr+は、陰極として作用しているターゲット表面で電子を受け取り、電気的に中性の状態で弾き返され、基板に向かって高速で(高い運動エネルギーを持った状態で)進みます。これは反跳アルゴンと呼ばれ、基板および成膜中の膜へ良かれ悪しかれの影響を与えます。
ここで、1つのAr+が弾き出すターゲット材料原子ないし分子の個数は、スパッタ率と定義されており、スパッタ率が大きい材料ほどスパッタレート(成膜速度)を大きくできます。
今までの話の中では、ターゲット材料と基板が共に導電性物質の場合です。では、ターゲット材料が絶縁体の場合はどうなるかと言いますと、直流のスパッタ電源では放電できないため、高周波(概ね10MHz以上:実際には使用できる周波数が法律で規制されているので、13.56MHzとか27.12MHzとか40.68MHzとかが使用でき、最も一般的なのは13.56MHz)のスパッタ電源を使用することで可能になります。この話は、また別のトピックスで改めてさせて頂きます。
それでは、基板がガラスやPETフィルムのような絶縁体の場合、前記した図1の構成では絶縁体基板の裏側に陽極が配置されているため、放電しない(プラズマが発生しない)ことになります。しかしながら、この場合、実際には放電しプラズマが発生します。したがって、実際には陽極として作用する部位が異なるのです。それは、ターゲットシールド或いはアースシールドと呼ばれる部品が、少なくともマグネトロンスパッタリングの場合には陽極として作用します。この話も、また別のトピックスで改めてさせて頂きます。図1と図2には、ターゲットシールドないしいはアースシールドが明記されていませんので、ご了承ください。さらに図1と図2では、プラズマの形状とマグネトロン磁気回路の形状が不明確なので、これはマグネトロンスパッタに特化したトピックスで話をさせて頂きます。
※.次回の予告
最後までお読み頂きまして、誠にありがとうございました。
今回は初回なので、スパッタリングの基本的なお話をさせて頂きました。既にご存知の内容だったかも知れませんが、もしかしたらなるほどと思われた点もあったのではないかと拝察します。
次回は、放電開始のメカニズムについてお話ししたいと考えております。私の話は、スパッタリングという技術に触れて間もない研究者や技術者の方々が、なるべくスパッタ装置の設計や使用に役立つよう配慮したいと考えています。
異論や反論がございましたら、どうぞお気軽にご意見を「お問い合わせ」フォーマットにてお寄せください。トピックス記事のリクエストも大歓迎です。可能な限りお応えしたく存じます。
末筆になりましたが、私の日本語に不自然な箇所がありましても、ご寛大なお心でご容赦ください。それでは次回、またご覧いただければ幸甚です。


